インフォメーション 半導体・センサ パッケージング技術展2023 出展のお知らせ
 2023年1月25日〜1月27日開催
2023年1月25日〜1月27日開催
丸文株式会社は2023年1月25日(水)から27日(金)まで行われる「半導体・センサ パッケージング技術展」に出展します。
最先端製品開発をテーマにした関連装置を紹介いたします。
展示内容
次世代パッケージング開発
【対象者】マイクロLED、3D実装、シリコンフォトニクス等の分野での超高精度実装が課題となっている方へ
【展示品】FC300
・ポストボンド精度(実装後の精度)±0.5µmを実現!
ハイブリッドボンディング対応機種
【対象者】ダイレクトボンディングやチップ to ウエハのような次世代接合にご興味をお持ちの方へ
【展示品】NEO-HB
・ポストボンド精度(実装後の精度)±1µmで、スループットが1000UPH対応可能な量産用途装置
半導体・センサ パッケージング技術展 概要
- 展示会名:半導体・センサ パッケージング技術展2023
- 会期:2023年1月25日(水)から27日(金)
10:00〜17:00 - 会場:東京ビックサイト
- 丸文ブースNo.:東3ホール No.26-34
- 「半導体・センサ パッケージング技術展2023」公式サイト
- 招待券の申し込みはこちら
※招待券をお持ちの場合展示会入場料(当日5,000円)が無料になります。
 会場案内図
会場案内図
次世代パッケージング開発向け装置
・微細化の限界に伴い、前工程・後工程の垣根を超えた新たなパッケージング技術となる高密度実装が求められています。
Post-bond(ボンディング後の)搭載精度±0.5umを達成する超高精度装置により、将来に向けた各種アプリケーションの開発、少量生産に対応いたします。
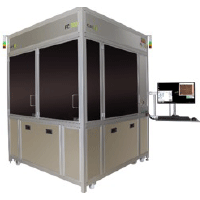
主な装置仕様(FC300)
・ポストボンド精度(ボンディング後精度)±0.5µm
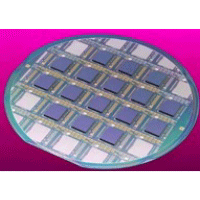
特長とアプリケーション
【特長】
ウェハ to ウェハやチップ to ウェハ接合に対応
【代表的なアプリケーション】
マイクロLED,量子コンピュータ,オプトエレクトロニクス,シリコンフォトニクスなど
【新機種】ハイブリッドボンディング対応装置
・R&Dや少量生産向け装置がメインラインナップでしたが、量産用途としてNEO-HBを新たにリリースしました。

主な装置仕様(NEO-HB)
・Post-Bond(実装後)精度:±1µm3σ
・スループット:1000UPH
・チップ to ウェハ ハイブリッドボンディング、ダイレクトボンディングに対応
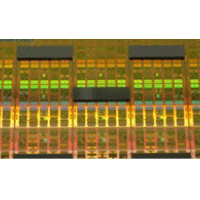
特長とアプリケーション
【特長】
チップ to ウェハを高スループットで実現することにより、接合不良チップを排出せず良品チップのみを超高精度でボンディング可能。
【アプリケーション】
量子コンピュータ、シリコンフォトニクス、オプトエレクトロニクスなど