CMPプロセスにおける計測管理の重要性

HPCやAIアプリケーションの進展に伴い、半導体製造では性能と機能の限界を突き詰めています。これに伴い、3D NANDの積層・DRAM積層(HBM)等からCMPプロセスによるウエハの平坦許容誤差はより厳しくなっています。
インテリジェント・ライン・モニタリングの実現
CMPプロセス制御へのアプローチ
- データ統合: スタンドアロン計測ツールから得られたデータを統合計測システムへ送ることで、リアルタイムかつAI駆動によるプロセス最適化を実現します。
- 中心技術: 高度な統合計測プラットフォーム「IMPULSE」が、スタンドアロンツールの「Atlas システム・IriSシステム」とモデリングソフトウェア「Ai Diffract™」を連携します。
- システム統合: スタンドアロンデータと局所的なTEM(透過電子顕微鏡)を組み合わせることで、高精度かつ高スループットな結果を導き出します。

主なメリット
- ソリューション構築の迅速化: スタンドアロンツールのパラメータをIMPULSEのレシピにフィードすることで、モデルの収束とプロセス調整が速まります。
- スループットの向上: 統合計測段階での事前測定を省略できるため、精度を損なうことなく時間を節約できます。
- コスト削減とTEM依存の低減: ハイブリッドモデルにより広範囲なTEMデータが不要になり、コストと開発期間を削減できます。
- プロセス制御の強化: AI分析とモデルベースのフィードバックにより、異常検知能力とプロセスの安定性が向上し、Cpk(工程能力指数)が改善されます。
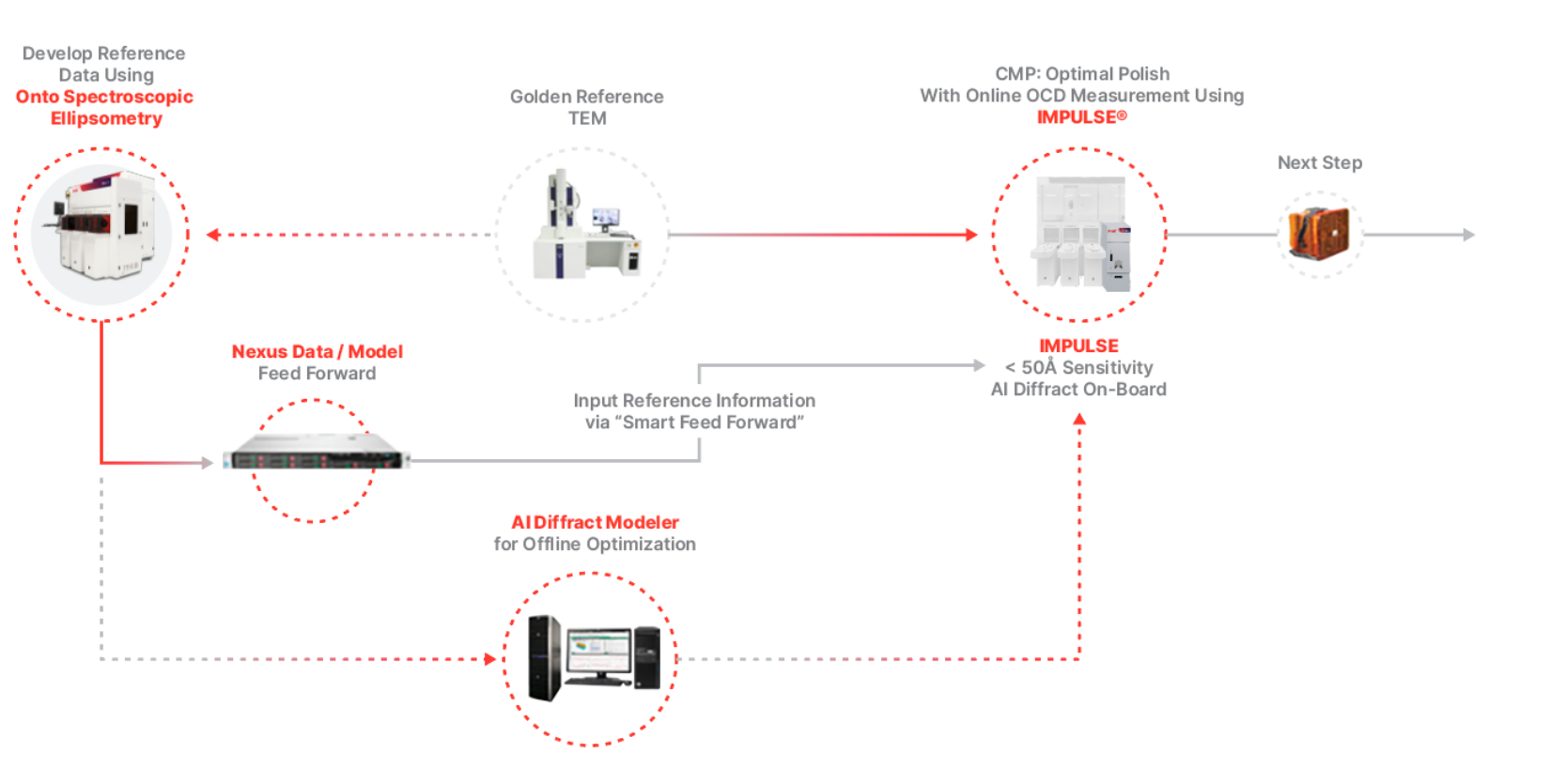
最後に
Onto社は世界中の半導体工場で最先端プロセスの製造における実績と確かなノウハウがあります。CMP以外にも欠陥検査においてもハイレベルなご提案が可能ですので、お気軽にご連絡ください。
著者名
会社名:丸文株式会社
部署名:システム営業第1本部 営業第3部 先進産業ソリューション第1課
執筆者名:佐々木 大成
関連商品
マクロ外観検査 Dragonfly G3
多様な照明設定と検査アルゴリズムにより様々な欠陥を検出すると共にNon-Killer欠陥の検出を最小限にすることを可能とした外観自動検査装置です。また、Xsoft(Operation Software)の採用により、操作性を飛躍的に向上させ、容易に検査レシピを作成することが可能です。
重ね合わせ検査装置(オーバーレイ検査装置)
本ページでは、Onto Innovation社のオーバーレイ検査装置についてご紹介します。オーバーレイ検査とは、露光後のマークの位置ズレを自動検査することを指します。
ウエハ膜厚/形状寸法計測装置 IRIS-S
メトロジー分野における高機能計測Iris S システムの紹介です。 アドバンスド・パッケージング等の最先端半導体市場向けに設計された、非常に汎用性の高い計測プラットフォームです。150mm、200mm、300mmの異なるウエハサイズに対応し、薄膜から厚膜、形状測定まで幅広い計測ニーズに応えます。
ウエハ膜厚/形状寸法計測装置 Iris-Sの資料ダウンロードはこちら>>



