フリップチップボンダーとは?

こちらのページではフリップチップボンダーの仕組みやメリット、高精度化が求められる背景・理由についてわかりやすく解説します。
フリップチップボンダーとは?
半導体チップを基板や半導体パッケージに高精度で接合するための装置です。
フリップチップ実装技術を用いて、チップを反転(フリップ)して、チップ上の接続バンプを基板の接続パッドへ直接接続します。
これにより、従来のワイヤーボンディングに比べて省スペース化や高スループット、低損失などのメリットがあります。
この技術は、3D積層実装や光デバイス、AIデバイス等の新しいアプリケーションにおいて更なる高性度のニーズが増え、今後も需要が増えると予測されています。
フリップチップボンディングの必要性
- 高性能化:フリップチップボンディングにより、チップと基板間の電気抵抗とインダクタンスが減少し、デバイス全体のパフォーマンスが向上します。
- デバイスの小型化:この技術は、コンパクトな実装が可能であり、携帯電話やコンピュータなどの電子機器の開発において重要な役割を果たします。
- 熱散逸の改善:フリップチップボンディングは、優れた熱散逸を実現し、高性能半導体や高出力用途に適しています。
- 省スペース:従来のワイヤーボンディングに比べて、フリップチップボンディングはスペースを節約し、高密度実装が可能です。
- 信頼性の向上:高精度な接合技術により、製品の信頼性が高まり、不良率が低減します。

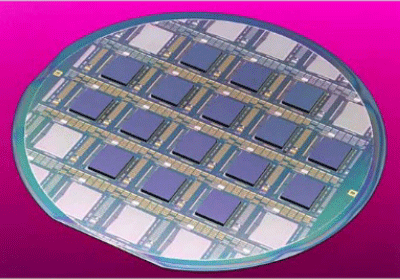
フリップチップボンディングにおいて高精度が重要な理由とは
- 半導体デバイスの超微細化:最新の半導体チップではトランジスタや配線の微細化が進み、接続点(バンプ)のピッチも縮小しています。これに対応するには、サブミクロン単位での搭載精度が必要です。
- 異種チップ統合(ヘテロジニアス・インテグレーション)の進展:AI処理用チップ、メモリ、センサーなど異なる機能を持つ複数のチップを一つのパッケージに統合する需要が高まっています。各チップの熱膨張率や材質の違いに対応した高精度なボンディングが求められます。
- 3次元積層技術の普及: チップを垂直方向に積層する3D-ICの普及により、層間接続の高密度化・高信頼性化が必要です。積層されるチップ間の位置ずれを最小限に抑え、安定した電気的接続を確保するため、高精度が不可欠です。
これらのニーズに応えるために高精度、接合ノウハウが必要となっています。
関連情商品・技術情報
高精度ボンディングにおける代表的なアプリケーション
超高精度 R&DフリップチップボンダーFC300(高加圧対応)
FC300は±0.3µmのボンディング精度を可能にする全自動フリップチップボンダーです。
最大φ300mmまでのサイズに対応しており、接着力も4000Nまでカバーしているため非常に幅広いアプリケーションに対応しております。
次世代に向けたR&Dから、完全自動化によるパイロット生産まで対応しております。
超高精度R&DフリップチップボンダーFC150 PLATINUM(多用途対応)
FC150 PLATINUMは±0.7µmのボンディング精度を可能にする全自動フリップチップボンダーです。
最大200mmまでのサイズに対応しており、IRセンサーやX線など幅広いアプリケーションの開発に理想的です。次世代に向けたR&Dから、完全自動化によるパイロット生産まで対応しております。