商品基礎情報
SEMI準拠の安全設計
対応規格
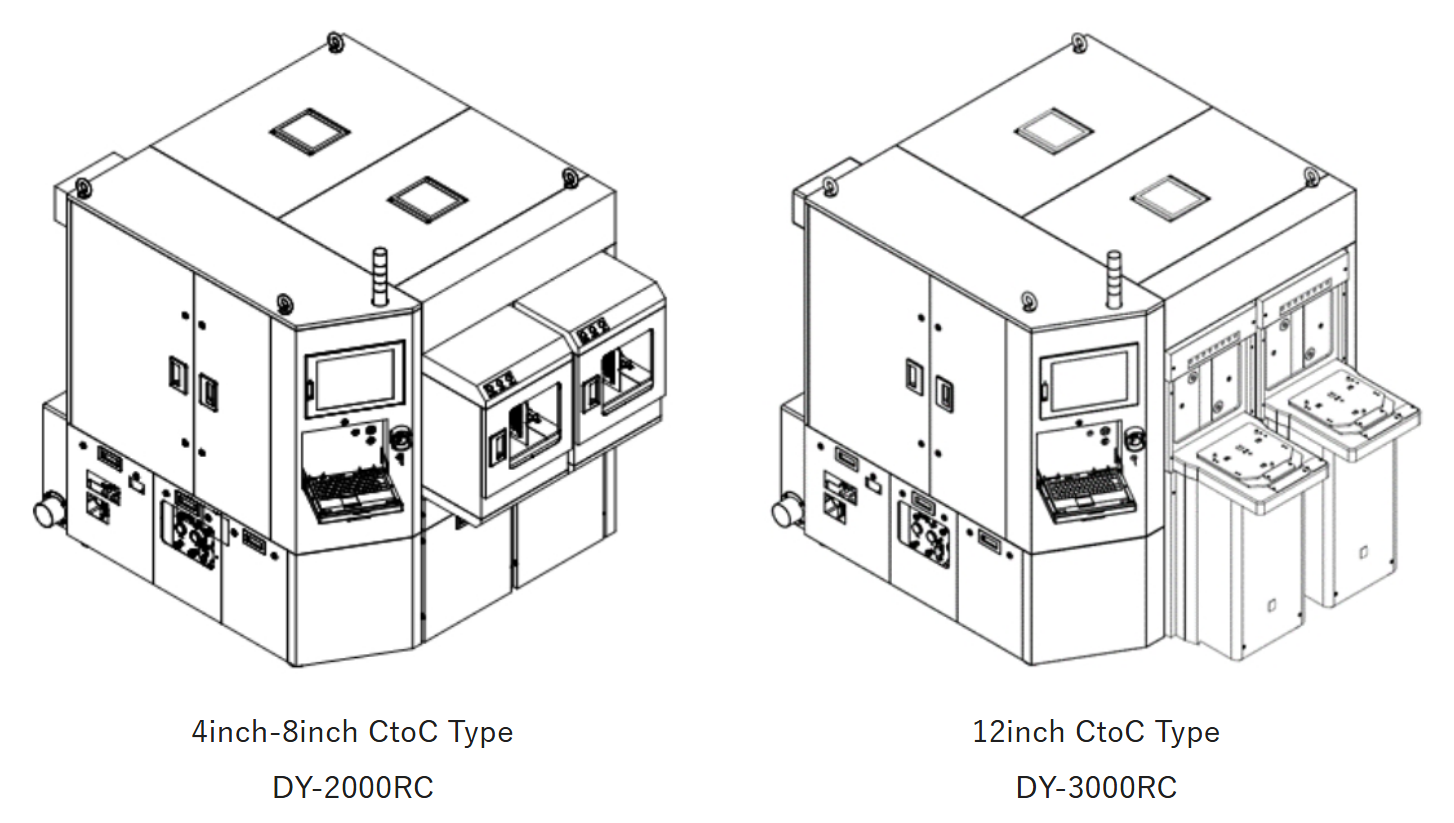
本装置は安全にご使用いただけるよう、各安全規格に対応した設計となっています。
・SEMI S2-0818
半導体製造装置の環境、健康、安全に関するガイドライン
・SEMI S8-0218
半導体製造装置の人間工学エンジニアリングに対する安全ガイドライン
・ISO 12100
機械類の安全性−設計原則
・IEC 602040-1
Safety of Machinery – Electrical equipment of machines –
SEMI規格測定などの解析項目に対応
解析ソフトウェア

測定データを用いての2D/3D 断面形状プロファイルの等の各種計測や Semi規格の「SORI」・「Bow」・「Warp」・「GBIR」などの様々な解析を行います。 CSV ファイルへのエクスポートや報告書作成に便利なレポート出力も可能です。
自重たわみ補正
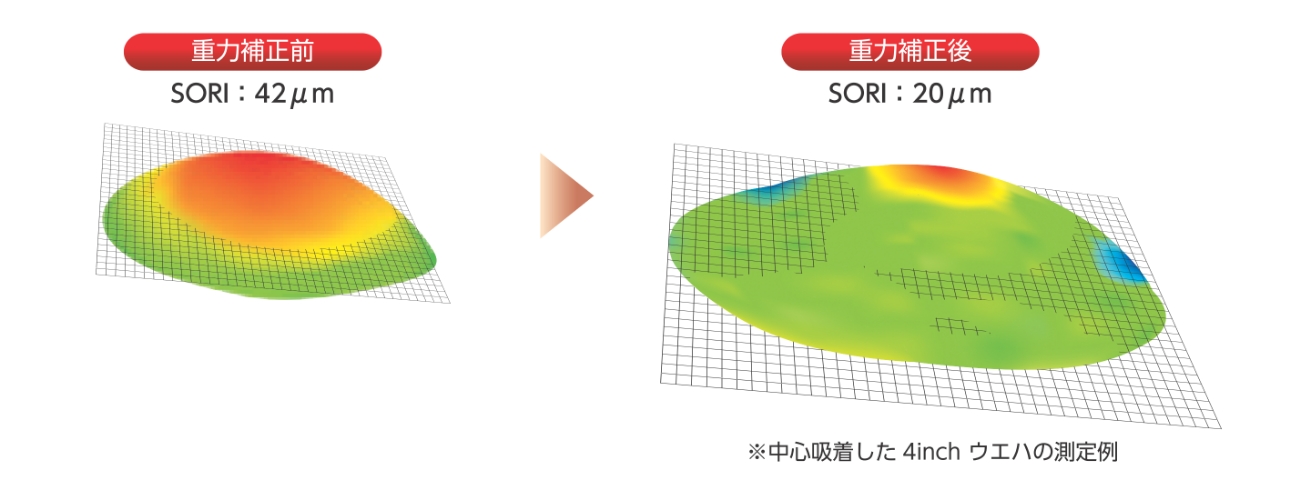 Gravity Correction
Gravity Correction
測定データを用いてウエハの自重起因のたわみを補正することにより、ウエハ本来のたわみデータを算出できます。 特に薄いウエハ・大口径ウエハに有効です。
 Sample Wafer Inversion Method
Sample Wafer Inversion Method
【両面差分モード】
ウエハの裏表両面の表面形状を測定し、そのデータの差分から自重たわみの影響を消した補正データをつくります。
 Theoretical Modeling Metho
Theoretical Modeling Metho
【理想モデル差分モード】
有限要素法により作成した自重たわみを含むウエハの理想モデルと測定データの差分から 自重たわみの影響を消した補正データをつくります。
基準ゲージを用いた補正機能
基準平面基板による補正(マッピング補正)
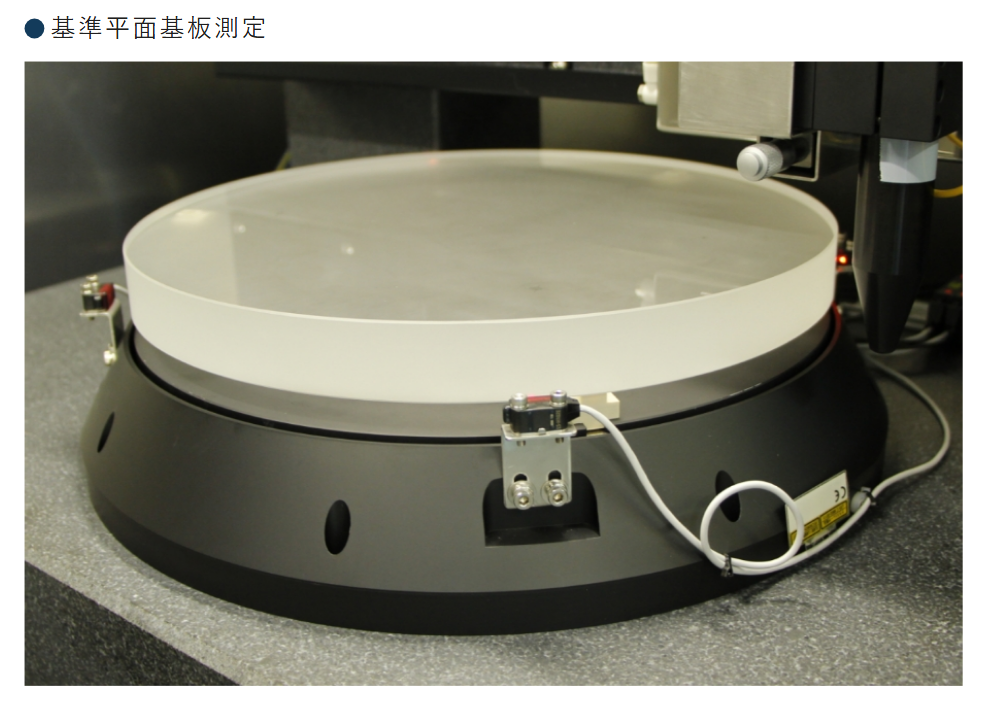 Mapping Correction
Mapping Correction
基準平面基板の表面高さデータを事前に測定し、補正データとして使用します。その補正データを実際のワークの測定データから差し引くことにより、スキャンステージの持つ微小な揺動を補正して、ワークの真値に近づけます。特に反りの小さなワークの測定に有効です。
成膜後の応力測定アプリケーション(オプション)
膜応力分布の測定ソフトウェア

成膜前後のSORI形状の測定データを用いて、ウェハの直径方向に対して解析ラインを指定し、それぞれのデータの曲率半径と設定パラメータに応じた膜応力の分布を算出します。また、断面ごとのプロファイルデータの算出やレポート出力もおこなえます。







