商品基礎情報
幅広いアプリケーション
電気的解析を伴う電子部品・電子モジュール・電子基板は全てELITE解析の対象となります。
これらの内部におけるショート・疑似オープンに起因して発生する特異な発熱パターンにより欠陥部位を特定することが可能です。
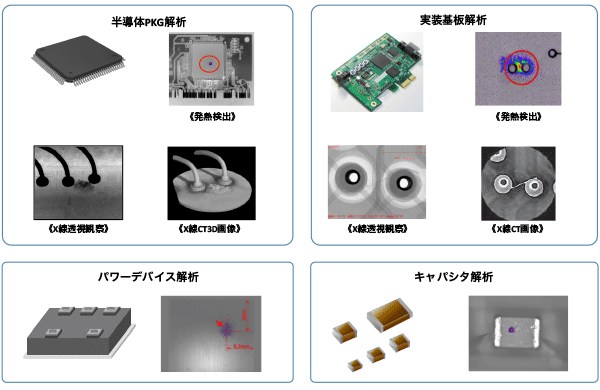 アプリケーション別 解析事例
アプリケーション別 解析事例
ELITE活用事例 ~X線CTとのコンビネーション~
- 迅速な可視化: ELITEで検出した発熱部位を3次元X線CTで観察することで、短時間で欠陥事象を可視化できます。これにより、故障解析のスピードが大幅に向上します。
- 正確な断層撮影: ELITEの位相データを基に対象ワークの深さ位置を指定することで、欠陥が発生した内層のCT撮影位置を正確に指定できます。これにより、より精度の高い3D断層画像が得られます。
- 効率的な解析: 発熱部位の特定とその後のCT撮影を組み合わせることで、解析プロセスが効率化され、全体の作業時間が短縮されます。
半導体パッケージ品の内部ショート
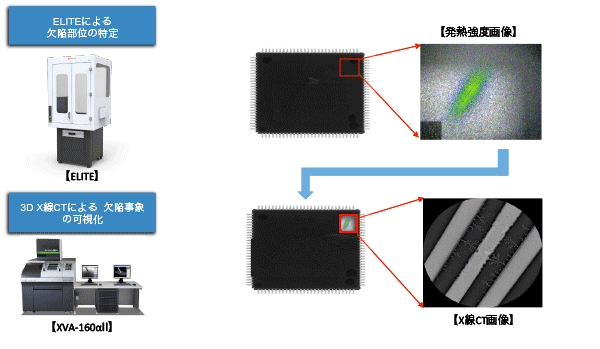
多層基板のVIA間ショート
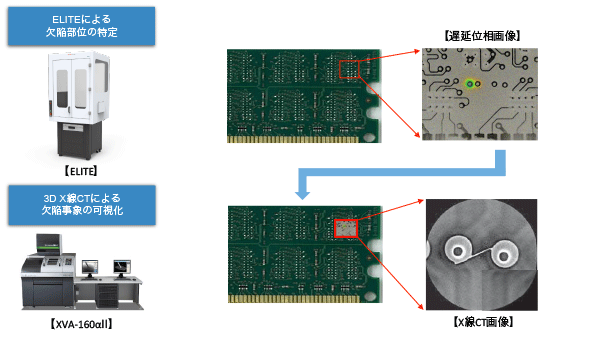
ELITE活用事例 ~レーザ開封とのコンビネーション~
- 精度の向上: レーザー開封装置 FALIT でデバイスを薄片化することにより、発熱箇所をより正確に特定できるため、故障解析の精度が向上します。
- 効率的な解析: 発熱箇所をピンポイントに絞り込むことで、解析プロセスが効率化され、時間とコストの削減に繋がります。
パッケージ内欠陥
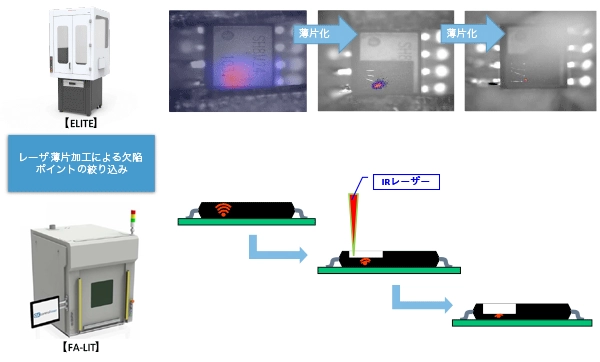
ELITE活用事例 ~ダイ回路上の欠陥検出~
樹脂モールド越しに非破壊で欠陥位置を特定し、その後開封して超高分解能のLSM(レーザースキャニングマイクロレンズ)を用いることで、ダイ回路上の欠陥をさらに絞り込むことができます。
- 高精度な欠陥特定: 開封後にLSMを使用することで、ダイ回路上の微細な欠陥を高精度で特定できます。
- 詳細な解析: LSMによる高分解能の画像取得により、欠陥の詳細な解析が可能となり、故障原因の特定が容易になります。”
ダイ回路上のESD欠陥
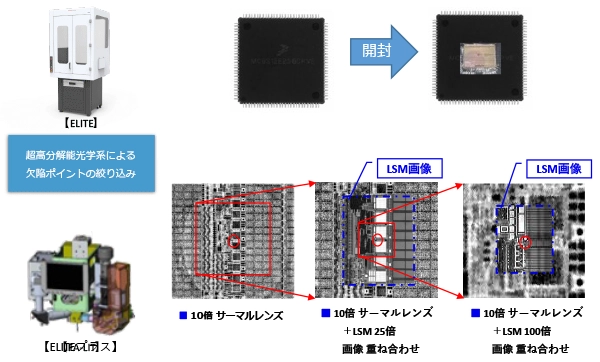
従来解析手法との比較
ELITE解析®と3次元X線CTの組み合わせは、非破壊解析工程におけるTAT(ターンアラウンドタイム)を大幅に短縮する強力なソリューションになります。
- 迅速な欠陥特定: ELITE解析®で欠陥部位を特定し、その後3次元X線CTで欠陥事象を確認することで、迅速かつ正確に欠陥を特定できます。
- 非破壊解析: サンプルを破壊せずに欠陥を特定・確認できるため、欠陥事象を消失するリスクを低減することが可能です。
- 効率的なプロセス: 非破壊解析工程で欠陥発生原因を仮定し、物理解析工程への正確な橋渡しを行うことで、全体の解析プロセスが効率化されます。





