故障解析ソリューション

丸文株式会社では、「研究開発向け品質管理」「製造検査」において、最先端の技術と豊富なラインナップを取り揃えております。
故障解析業務における一連の作業の中で、非破壊解析・開封・物理解析までの工程を全て網羅した幅広いソリューションをご提供します。
研究解析向け品質管理
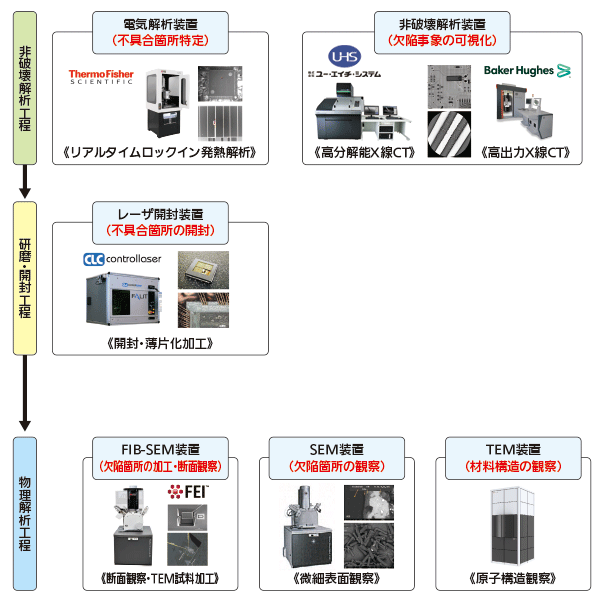
日本エフイー・アイ|リアルタイムロックイン発熱解析装置 ELITE -特長-
ELITE解析は、高感度赤外線カメラとロックイン技術を組み合わせることで、半導体・電子部品・実装基板の不具合箇所を非破壊で特定することが可能です。
一般的なサーモグラフィとの違いとして、ELITE解析は不具合箇所をピンポイントで可視化できる点が挙げられます。これにより、故障解析の初期段階で正確に故障部位を特定し、その後の解析業務を大幅に効率化することができます。
こちらのページではELITEの基本概念と特徴をご紹介致します。
日本エフイー・アイ|リアルタイムロックイン発熱解析装置 ELITE -基本仕様-
ELITE解析は、高感度赤外線カメラとロックイン技術を組み合わせることで、半導体・電子部品・実装基板の不具合箇所を非破壊で特定することが可能です。
一般的なサーモグラフィとの違いとして、ELITE解析は不具合箇所をピンポイントで可視化できる点が挙げられます。これにより、故障解析の初期段階で正確に故障部位を特定し、その後の解析業務を大幅に効率化することができます。
こちらのページではELITEの基本仕様をご紹介致します。
日本エフイー・アイ|リアルタイムロックイン発熱解析装置 ELITE -アプリケーションと有効性-
ELITE解析は、高感度赤外線カメラとロックイン技術を組み合わせることで、半導体・電子部品・実装基板の不具合箇所を非破壊で特定することが可能です。
一般的なサーモグラフィとの違いとして、ELITE解析は不具合箇所をピンポイントで可視化できる点が挙げられます。これにより、故障解析の初期段階で正確に故障部位を特定し、その後の解析業務を大幅に効率化することができます。
こちらのページではELITEのアプリケーションと有効性をご紹介致します。
プラズマFIB-SEM Helios 5 PFIB
FIBのイオン源にXe プラズマイオンを搭載しております。
GaタイプのFIBでは得られない大電流高速加工により、広範囲の断面作成、3D解析ならびにTEM試料、各種分析の搭載が可能な装置です。
日本エフイー・アイ|フルデジタル透過電子顕微鏡 | Talos S/TEM
Talosは、走査・透過型電子顕微鏡(S/TEM)であり、多次元に渡るナノ材料において、高スループット、多目的、多次元の解析に最適な最高加速電圧200kVのS/TEMシステムです。
Emission・OBIRCH複合装置 | Meridhian
Emission、OBIRCH、レーザープロービングによる動的解析まで、解析ニーズを幅広くカバーできる装置です。
3次元X線CTシステムの特徴
こちらのページでは、ユー・エイチ・システム社のナノ/マイクロフォーカス3次元X線CTシステムの特長をご紹介いたします。
ユーセントリック機構、3次元斜めCT機能など独自の技術をベースに、超高倍率での透過/CT撮影が可能な3次元X線CT装置です。
自社開発による独自のソフトウェアで、ユーザーの皆様から高評価な性能、使い勝手を実現しております。
3次元X線CTシステムのラインアップと各製品のスペック
こちらのページでは、ユー・エイチ・システム社の3次元X線CTシステムのラインアップをご紹介いたします。
ユーセントリック機構、3次元斜めCT機能など独自の技術をベースに、超高倍率での透過/CT撮影が可能な3次元X線CT装置です。
自社開発による独自のソフトウェアで、ユーザーの皆様から高評価な性能、使い勝手を実現しております。
CLC|レーザー開封装置 FA-LIT ~特徴~
本装置は、米国Control Laser Corporation社製、半導体ICデバイス不良・故障解析用パッケージのレーザー開封装置FALITです。
レーザースキャニングによるドライプロセスでのプラスチックモールドの開封プロセスをライブ画像で観察しながら、短時間で、樹脂・プラスチックモールドのみを選択的に開封します。
CLC|レーザー開封装置 FA-LIT ~ラインアップ~
本装置は、米国Control Laser Corporation社製、半導体ICデバイス不良・故障解析用パッケージのレーザー開封装置FALITです。
こちらのページではレーザー開封装置のラインアップをご紹介します。












